
用于超薄扇出堆叠型封装的激光剥离
发布时间:2018-04-16
据麦姆斯咨询报道,扇出型封装(fan-out packaging)是应用于众多移动应用的成熟技术。早期的半导体封装一直是单芯片封装,为支持功能增加导致布线密度越来越大的发展趋势,要求更复杂的封装、堆叠封装(stacked packages)、系统级封装(systems inpackage),同时还要满足高性能。随着技术的发展,扇出型封装正在缩小成本与高性能之间的矛盾。无论是为满足更小尺寸的需求使晶圆变薄,实现焊料成本的节约,还是作为重新布线层(redistribution-layer,RDL)首步工艺的工艺平台,所有封装均需要临时键合(temporary bonding)。
临时键合需要键合(bonding)和剥离(debonding)两种工艺。从扇出型晶圆级封装(fan-out wafer-level packaging,FoWLP)到功率器件,每种应用在工艺温度、机械应力和热预算等方面都有独特的要求,因此确定合适的剥离技术比较困难。这里只是枚举了几个例子,实际情况更为复杂。我们将在本文中重点讨论激光剥离(laser debonding):如抗高温更兼容的材料可应用于哪些情况,激光剥离的特性适于哪些应用等。
为了控制剥离带来的热输入,紫外激光(UV lasers)常被用于剥离不同材料供应商提供的不同临时键合材料。为了确保最低的维护工作量,二极管泵浦固体激光器(diode-pumped solid-state,DPSS)可将高度工艺控制的光束整形光学(beam-shaping optics)与最低热输入相结合,不失为是一项正确的选择。
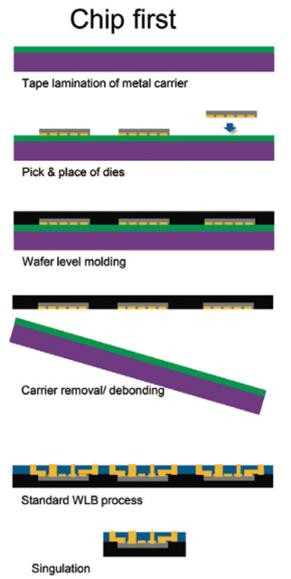
图1 Chipfirst扇出型晶圆级封装制造工艺流程示意图
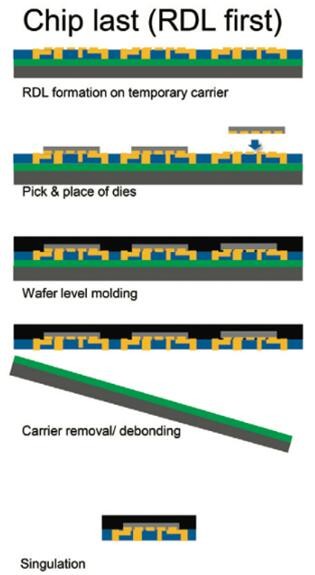
图2 Chiplast扇出型晶圆级封装(又称RDL first)制造工艺流程示意图
扇出型晶圆级封装(FoWLP)中临时键合面临的挑战
FoWLP能在行业内收获巨大利益,一定程度上取决于其采用了载板(carrier),临时键合材料对化学和热兼容性的要求很高。某些聚酰亚胺符合这种严苛的环境,也适用于激光剥离。
尽管键合和剥离都是FoWLP的工艺,但两者的需求差异很大。通过观察各种应用中不同的半导体工艺,显然没有任何一种剥离工艺解决方案可与所有的半导体工艺兼容,多个解决方案是必然选择。这就是开发出的各种各样的剥离工艺(剥离技术是临时键合的特征)至今仍都在使用的原因。
主流剥离技术的比较
最常见的方法有:热滑动剥离(thermal slide-off debonding)、机械剥离(mechanical debonding)和紫外激光剥离(UV laser debonding)。这三种方法均适用于大批量生产,在工艺兼容性方面差异巨大。
热滑动剥离(thermal slide-off debonding)是一种利用热塑材料作为器件与载板晶圆(carrier wafer)之间粘合夹层(adhesive interlayer)的方法。该方法利用了热塑材料的可逆热特性,意味着在较高的温度下,该材料的粘度会下降,从而能通过简单地滑动两边的晶圆来完成剥离。热剥离的特点是根据热塑材料的温度特性,使用范围在130°C到350°C之间,因此在较高的温度下就可完成键合与剥离。温度稳定性在很大程度上取决于机械应力,我们可以观察到这是由于热塑材料在高温下具有低粘度。
机械剥离(mechanical debonding)是一种高度依赖晶圆表面特性、临时键合材料的粘附力和内聚力的方法。对于大多数材料系统,均可使用机械释放层(mechanical release layer)来实现可控剥离。机械剥离的主要特点是:可在室温下处理,且强烈依赖机械应力。由于机械剥离需要在临时键合材料与晶圆间产生低粘附力才能成功剥离;因此,在FoWLP应用中使用这种方法是有些困难的。这是因为FoWLP工艺中产生的较高应力会导致自发性的剥离,甚至在减薄工艺中也会出现,这就会导致良率的急剧下滑。
激光剥离(laser debonding)是一种通过几种不同的变量来实现剥离的技术。该方法的剥离机制依赖于:激光种类、临时键合胶,以及用于该工艺的特定释放层。红外激光剥离依靠热过程进行工作:将光吸收并转化为热能,从而在键合界面内产生高温。紫外激光剥离则通常依靠化学过程进行工作:使用光吸收的能量来破坏化学键。破坏聚合物的化学键会导致原始聚合物进行分解。分解物包括气体,就会增加键合界面的压力,因而帮助剥离。由于在剥离工艺前,临时键合胶对晶圆具有很高的粘附力,因此这种方法非常适用于FoWLP应用中。
扇出型晶圆级封装(FoWLP)应用的优化解决方案
据麦姆斯咨询介绍,由于剥离过程中的热输入是有限的,因此紫外激光在FoWLP中更具优势。载板晶圆必须能通过紫外激光的穿透,以确保激光能量的有效利用,延长载板晶圆的寿命。目前有两种主要类型的紫外激光(全固态激光和准分子激光),每种激光均可选多种波长。波长大于300nm的激光是最理想的选择,出于以下两个原因的考量:首先,市场可选用的激光剥离材料的波段可有效吸收和剥离高于300nm波长的激光;其次,因为玻璃能够在该波段范围内实现高传输,即该波段激光允许采用标准玻璃晶圆作为载板。
由于全固态激光无需定期更换卤素气体,因此维护成本较低。而且功耗非常低,以每周工作7天、每天工作24小时的功耗来计算,全固态激光可运行5年。此外,由于光学设置紧凑,对实现更小尺寸的引脚有利。图3为全固态激光常见的高斯光束。

图3 通常全固态激光要求高脉冲重叠。重叠区域表示激光剥离中所使用的辐射照射(radiant exposure),而红色区域则表示不能用于剥离的能量
紫外激光剥离对辐射能量有阈值要求,这意味着在辐射照射特定值以上发生剥离。在图3中,重叠区表示辐射照射适于剥离。低于或高于该值的能量(图中红色区域)均不能剥离,通常就转化为热能,这就会导致碳化和产生粒子。由于在高斯分布边缘的激光束缺少足够的能量,所以必须有一定的脉冲重叠,这时额外的变量优化是必须的,以便在没有碳化时成功剥离。此外,光束中心的多余能量会导致碳化。高斯分布的光束不适合限制剥离中的热效应。
通过使用专用光学装置进行光束整形,高斯光束可被整形成近top hat光束。通过使用这种光学装置,可得到用于剥离的重复性好的光束,形貌与图4中top hat光束相似(在此基础上,光束的形状不会随时间而改变),从而限制热输入。与这种激光的高脉冲重复率相结合,就可实现更严格的工艺控制,并且能够扫描固定晶圆的表面,从而实现剥离工艺的高产出。图5描绘了扫描过程,与准分子激光相比,晶圆固定在静止的载台上,激光点由晶圆上方的扫描振镜(galvo scanner)控制,整个剥离过程速度较快,可以实现高产出。

图4 先进的紫外激光解决方案,利用光束整形光学将高重复性扫描与激光能量效率相结合。在重叠区域中,用于剥离的辐射照射效率非常高

图5 EVG激光剥离解决方案,是将全固态激光与光束整形光学结合起来,以实现高产出的可控过程
如图6所示,测试晶圆被用于确定剥离的最佳辐射照射值。即使是top hat光束,为减少热效应,辐射照射值接近于剥离阈值是非常重要的。尽管如此,较少的重叠部分也是必要的,因为临时键合材料与晶圆间的粘附力非常高。
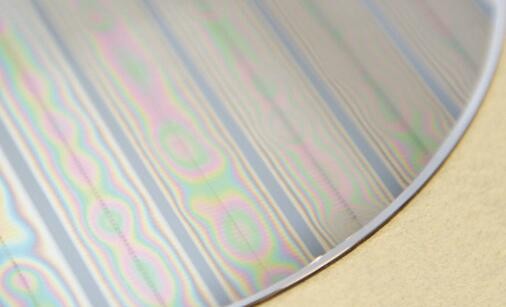
图6 用于激光剥离的测试晶圆,不同的轨道代表了不同激光的剥离效果
未来扇出型晶圆级封装(FoWLP)的临时键合
超薄扇出堆叠型封装(FoWLP),也被称为层叠封装(Package on package,PoP),由于此类封装能大幅提高器件密度,目前已被纳入多种应用的技术路线图之中。然而,未来PoP对重新建构晶圆(reconstituted wafers)要求厚度更薄,这将为临时键合带来更多挑战。例如,由注塑(molded)晶圆与载板晶圆堆叠组成的临时键合晶圆的弯曲度(bow)必须最小化,以确保减薄均匀。最大总厚度变化(TTV)的规范也会根据最终晶圆的厚度变得更严格。对于不同的3D应用,涉及连线的问题,如选择“via first”还是“via last”,在PoP中也变得多了起来。虽然有多个工艺可选,但没有哪家扇出型封装企业已具备标准的工艺流程。
总结
由于紫外激光可在室温下进行剥离,且可以使用化学性质稳定的材料,因此紫外激光剥离是一种既适用于chip first,也适用于chip last(或RDL-first)扇出型晶圆级封装(FoWLP)的方法。本文介绍的紫外激光剥离解决方案不仅结合了全固态激光的优点,具有维护成本低、功耗低的优点,由于特殊的光束整形光学,还实现了高脉冲频率与高空间控制的结合。





